為了達成良率與元件效能需求,控制制程變異性,取得可重復的穩定結果是非常重要的。隨著技術節點的進展,以及設計規則的改變,業界需要更嚴格的制程控制。有許多因素會造成變異性,所有的案例一般可歸納為:在晶粒中、晶圓、晶圓到晶圓、以及腔體到腔體。
通常,晶圓變異只能低于整體變異性的三分之一。例如,在14奈米節點,閘極關鍵尺寸(CD)的允許變異值為低于2.4奈米,其中晶圓變異只能允許約0.84奈米。在5奈米節點,晶圓的允許變異值低于0.5奈米,這相當于2到3個矽晶原子的大小。在本文中,我們將討論如何在電漿蝕刻制程中控制晶圓的制程均勻度,此技術在業界的演進,以及其他的重要議題。
達成均勻度有難度 蝕刻腔體設計再進化
在蝕刻制程中控制均勻度的主要挑戰,在于電漿組成粒子的復雜度。若要達到滿意的蝕刻結果(即對不同選擇比的薄膜材料經過蝕刻后的結構剖面),需要管理不同離子與中子的比例(如Ar+、C4F8、C4F6+、O、O2+)。因為相同的電漿會產生兩種類型粒子,而且離子對中子的相對數量是息息相關的。因此,參數的影響通常會被用來控制電漿,如電漿供應源功率和蝕刻腔體壓力,其也是彼此相關的。
自從單晶圓制程于1980年代初期開始使用以來,蝕刻腔體被設計用來在晶圓的每個位置上產生相似的電漿條件,以達到均勻的制程結果。但是因為晶圓邊緣(圖1)會有固有的電氣與化學不連續性,會影響晶圓的均勻度,因此會使此目標的達成特別困難。由于從偏壓面到接地或懸浮面的改變,因而造成了電壓梯度在晶圓邊緣產生。
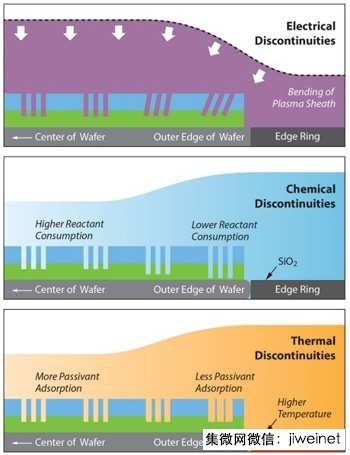
圖1 晶圓邊緣的不連續性會產生梯度,影響了晶圓表面的均勻度,并會在晶圓邊緣處造成重大影響。
這會使電漿鞘層(plasma sheath)在晶圓邊緣處彎曲,而改變了離子相對于晶圓的沖撞軌跡。潛在的化學不連續性也是同樣的情況,會使不同的物質在晶圓上產生濃度梯度。此梯度是由多種現象造成的,包括反應物消耗的變異性、以及中心相對于邊緣的副產品排放率,以及蝕刻腔體和晶圓的溫度差異,會造成化學物質的不同吸收率。
過去幾年來,蝕刻腔體的設計有了許多的改變,以改善徑向對稱性(圖2A)。舉例來說,電容式耦合電漿(CCP)蝕刻腔體的主要硬體參數,是陰極與陽極之間的間隙。傳統以來,此間隙的設計是用來為特定的功率、壓力、以及氣體化學混合物提供最均勻的蝕刻結果。在電感式耦合電漿(ICP)蝕刻腔體中,氣體注入的位置是一項重要的設計特性,而且會依制程而有所不同。在鋁蝕刻腔體中,反應物氣體是從晶圓上方的蓮蓬頭送出的。針對矽晶蝕刻,反應物氣體是從晶圓周圍注入的,但后來演進為氣體是從晶圓的中央上方注入。

圖2 制程的不均勻度可分為徑向以及非徑向(A)。在一張顯示整體不均勻度的晶圓圖上,若移除徑向對稱性,可找到更困難的非徑向不均勻度(B)。
隨著蝕刻腔體設計的持續優化,非徑向式分布的腔體設計已更為普遍。在均勻度晶圓圖上,能取得每個半徑中所有點的平均值并從晶圓圖中扣除,以找出較困難的不對稱部分(圖2B)。了解此特性后,焦點便移轉至消除蝕刻腔體設計中的不對稱性現象。
回顧過去,業界取得了一些非常明顯的進步。例如,一直到1990年代末期,都還是普遍把具備渦輪分子(turbomolecular)幫浦的蝕刻腔體放置在晶圓側邊。但是由于反應物的對流以及橫跨整個晶圓的副產品,這樣的設計會形成偏向一邊,有特定方向的均勻度分布圖結果。透過把幫浦移到晶圓下方,反應物流動便成為徑向對稱,因此能消除制程的不對稱性。
在其他的情況中,造成非對稱性的原因是更細微的。有一個令人感到興趣,且可以透過設計來修正的非均勻度情況,是腔體與腔體之間,彼此的座向方位不同,但卻都有著特定偏向同一邊的均勻度分布圖。在詳細研究并移除蝕刻腔體硬體可能的問題來源后,發現此圖樣是與地球的磁場有關(圖3)。這個例子說明了電漿制程的敏感度,即使是極微小的外部因素也會帶來影響。雖然不一定是蝕刻腔體的問題,但透過在蝕刻腔體四周采用高導磁性材料做為特殊屏蔽,此問題便被解決了。
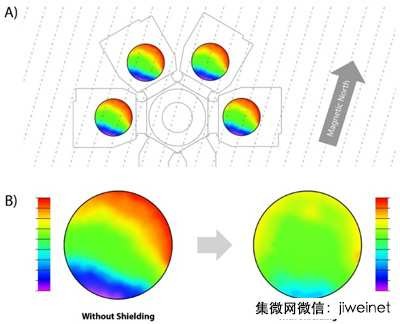
圖3 地球磁場造成的非均勻度可從蝕刻制程中確認出來(A)。利用磁屏蔽來修正這個問題,可取得一致的蝕刻結果(B)
因應晶圓靈活需求 制程微調應運而生
由于蝕刻制程越來越多樣且復雜,固定的蝕刻腔體設計,已不再具備可滿足嚴格需求的靈活性,因為替每一種蝕刻制程,提供特定的最佳化均勻度組件(Uniformity Kit)是不切實際的。特別是,在2000年代初期,當蝕刻制程從8寸晶圓移轉至12寸晶圓時,要獲得均勻度結果變得更不容易。因此,業界便開發出微調(tuning)功能,以為各種制程以及較大晶圓尺寸,提供所需的均勻度控制技術。
在2000年代初期,第一個均勻度的調變方式是針對控制晶圓上的化學作用。要達成此目標有好幾種方法,例如,把主要的反應物氣體分離到不同的位置上,或是在主反應物氣體之外的其他位置增加微調氣體。自此之后,蝕刻制程便有了多項可微調的參數(表1)。

理想上,列表中,上下(獨立)可調變方式,是用來對均勻度造成影響的可能因子,進行匹配補償的,盡可能去補償可能導致均勻度不佳的因子。這給制程帶來最大的沖擊,并限制了其他參數的影響。例如,在許多的介電質蝕刻制程中,蝕刻率受限于電漿的離子流量。因為氣體注入不會顯著影響電漿密度的均勻度,科林研發為CCP蝕刻腔體開發了可微調間隙技術,因此能針對特定的制程條件組合,達成整個晶圓的均勻度離子流量。
過去幾年來,持續的開發工作專注于增加空間解析度,以取得晶圓的更佳控制。
舉例來說,氣體一開始只是從晶圓上方的中央位置注入。之后,增加了額外的功能,可用來控制氣體直接注入晶圓中央或邊緣的比例。幾年之后,又在晶圓周圍增加了注入氣體的位置。為了利用晶圓溫度作為控制旋鈕,可將不同的加熱或冷卻區域加到承載晶圓的靜電式晶圓座(ESC)中。傳統以來,溫度區域的數目已從1到2(2002年),增加到4個徑向區域(2006年),以提升CD的徑向均勻度。由于溫度會直接影響CD均勻度(CDU),這是克服最重要的均勻度挑戰的一個有效方法。
一些今日最復雜的制程,得依賴這些先進的微調功能。推動制程持續微縮的一些創新技術,包括3D FinFET元件、先進記憶體設計、以及雙重/四重曝光技術,已為降低變異性帶來了更多的挑戰,因為整合流程中的制程步驟越來越多。即使個別單元制程(包括蝕刻)的均勻度不錯,但是它們的綜合影響可能會很顯著,因此需要在流程中的某些步驟中進行補償。
當上下游制程步驟所導致的均勻度結果是已知的且不易修正時,是可以改變蝕刻步驟影響均勻度的結果。例如,如果一個步驟是晶圓中心的蝕刻率快,蝕刻能透過邊緣快速來補償。這聽起來好像很簡單,但要達成這樣的制程控制程度實際上是很困難的,相當于要在另一個制程中提供此非均勻度的翻版。幸運的是,電漿蝕刻技術已經成熟,能夠達成這樣的控制程度。
在多年的創新之后,現在,均勻度控制已具備下列特性:
● 高度的精細度(晶圓上有多個獨立的微調位置)
● 主動微調徑向與非徑向圖樣
● 藉由調整蝕刻制程的前后步驟進行補償的能力
控制多獨立加熱器 均勻度關鍵參數掌握在手
想要達到現在所需的控制程度,科林研發采取的策略是提供多個獨立的加熱器,或是以微區域(micro-zone)來控制晶圓溫度,這是影響CD均勻度的關鍵參數。
例如,在每個蝕刻腔體利用超過100個局部加熱器,與整個晶圓只利用兩個或四個加熱器的系統相比,可提供更高的空間解析度。控制多個獨立的加熱器,可同時微調徑向與非徑向圖樣,然而在先前的世代中,只有中心─中間─邊緣的微調功能(圖4)。

圖4 主動式均勻度控制,已從晶圓較大區域的有限徑向微調,朝晶圓更小區域的獨立微調演進,可實現徑向與非徑向的均勻度控制。
由于精細度很高,個別工程師很難以手動方式,為這么多的加熱器決定適當的設定,以達到晶圓的目標熱圖樣。為了解決這個問題,我們開發了先進的演算法與特殊的溫度校正器,因此系統能自動控制加熱器。此外,要決定可達成所需的制程均勻度的熱圖特性也很困難。透過先進的軟體演算法,可利用制程趨勢、蝕刻腔體校正資料、以及晶圓檢測資訊,來自動產生適當的熱圖(圖5)。藉由這項能力,在蝕刻之后,可以將黃光之后,進蝕刻之前的CD不均勻度降低到小于0.5nm。
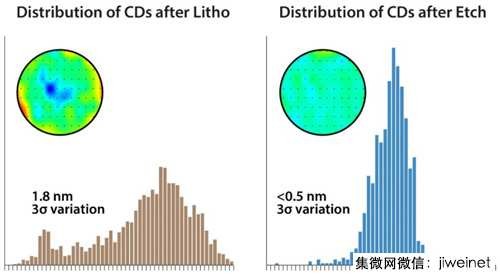
圖5 特定的硬體及軟體作圖。顯示前段微影制程的CD分布,以及可以在整個晶圓上的多個微區域調整蝕刻制程條件,以補償上游微影制程的變異性。
均勻度扮良率要角 補償制程控制發展不停歇
除了文中討論的均勻度挑戰,晶圓邊緣的效能─外圍10mm的區域,大約有10%的晶粒會在這個區域,其已成為未來提升良率的一個日益重要焦點。在此區域中,均勻度控制主要受到晶圓邊緣的電氣不連續性所影響,并會造成電漿鞘層彎曲。
與化學或熱效應影響的區域相比(分別為50-70或30-50mm),電漿鞘層彎曲的區域小了許多(離邊緣約10~15mm)。雖然固定的邊緣硬體,能被重新設計以優化均勻度,但新的技術正在發展中,以便能在晶圓邊緣提供電漿鞘層的內部可微調功能。
展望未來,我們預期,會有更多型態的控制旋鈕以及更高的精細度出現,以便能以更佳的自動化程度,實現更細微的制程調整。隨著制程模組日益復雜,補償式制程控制仍將會持續進展并運用。